晶圓直接鍵合及室溫鍵合技術(shù)研究進(jìn)展
晶圓(Wafer)是生產(chǎn)集成電路所用的載體,由于其形狀為圓形,故由此而得名,又被稱(chēng)為晶片或圓片。自1958年第一塊集成電路誕生以來(lái),硅工藝在集成電路的生產(chǎn)中占主導(dǎo)地位,硅晶圓是制造半導(dǎo)體芯片的基本材料。隨著對(duì)集成電路要求的不斷提高,其他半導(dǎo)體材料的應(yīng)用也越來(lái)越多,如鍺、砷化鎵、碳化硅等。鍵合(Bonding)可以將兩個(gè)或多個(gè)材料(或結(jié)構(gòu))結(jié)合成為一體,是半導(dǎo)體制造過(guò)程中不可缺少的重要環(huán)節(jié)。晶圓直接鍵合(一般簡(jiǎn)稱(chēng)為“晶圓鍵合”或“直接鍵合”),可以使經(jīng)過(guò)拋光的半導(dǎo)體晶圓在不使用粘結(jié)劑的情況下結(jié)合在一起,在集成電路制造、微機(jī)電系統(tǒng)(MEMS)封裝和多功能芯片集成等領(lǐng)域具有廣泛的應(yīng)用。為了盡可能減小傳統(tǒng)的高溫硅熔鍵合(800~1000)℃所引發(fā)的多種材料、結(jié)構(gòu)間的熱膨脹和熱應(yīng)力,如何在較低退火溫度條件下實(shí)現(xiàn)半導(dǎo)體晶圓鍵合是研究者們關(guān)注的問(wèn)題。美國(guó)電化學(xué)學(xué)會(huì)以晶圓鍵合科學(xué)與技術(shù)為主題,每?jī)赡昱e辦一次國(guó)際學(xué)術(shù)研討會(huì)。近年來(lái)低溫鍵合(<200 ) ℃工藝被認(rèn)為是發(fā)展的主流,其相關(guān)研究已在美國(guó)、歐洲和日本等諸多大學(xué)和研究機(jī)構(gòu)中廣泛開(kāi)展。其中無(wú)需加熱的室溫鍵合(約25 ℃)技術(shù)更被視為下一代制造工藝的備選,半導(dǎo)體制造的相關(guān)廠商也均投入大量研究經(jīng)費(fèi),開(kāi)發(fā)室溫鍵合方法及工藝,因此開(kāi)展室溫晶圓直接鍵合研究,對(duì)于推動(dòng)半導(dǎo)體產(chǎn)業(yè)的進(jìn)步具有重要的科學(xué)意義與現(xiàn)實(shí)要求。
文中將首先介紹傳統(tǒng)的高溫硅熔鍵合方法,而后針對(duì)兩類(lèi)室溫鍵合方法(真空環(huán)境和大氣環(huán)境中的鍵合)的研究進(jìn)展分別進(jìn)行歸納和總結(jié),并給出利用含氟等離子體表面活化在室溫晶圓鍵合方面取得的最新進(jìn)展。
1.硅熔鍵合
硅晶圓直接鍵合技術(shù)誕生于20世紀(jì)80年代,由美國(guó)IBM公司的Lasky和日本東芝公司的Shimbo等人所提出[3—4]。該技術(shù)是把兩片鏡面拋光硅晶圓片(氧化或未氧化均可)經(jīng)表面清洗,在室溫下直接貼合,再經(jīng)過(guò)退火處理提高鍵合強(qiáng)度,將兩片晶圓結(jié)合成為一個(gè)整體的技術(shù)。為獲得足夠高的硅-硅晶圓鍵合強(qiáng)度,往往需要施加較高的退火溫度(800~1000) ℃,與硅材料的熔點(diǎn)(1410) ℃ 較為接近,因此該方法又常被稱(chēng)為硅熔鍵合或熱鍵合法(Fusion bonding)。美國(guó)IBM公司利用硅熔鍵合與離子注入技術(shù)相結(jié)合,成功制備了絕緣襯底上的硅(Silicon-on-insulator, SOI)晶圓。由于SOI結(jié)構(gòu)在提高半導(dǎo)體器件性能方面具有體硅晶圓所無(wú)法比擬的優(yōu)點(diǎn),晶圓直接鍵合的方法開(kāi)始受到廣泛關(guān)注。
根據(jù)清洗后硅片表面所呈現(xiàn)的狀態(tài)不同,該方法又可分為親水鍵合(hydrophilic bonding)與疏水鍵合(hydrophobic bonding)兩類(lèi),原理見(jiàn)圖1。 20世紀(jì)90年代伊始,以美國(guó)杜克大學(xué)的童勤義和德國(guó)馬克斯-普朗克研究所的G?sele為代表的研究者經(jīng)過(guò)大量的實(shí)驗(yàn),系統(tǒng)研究了退火溫度對(duì)兩類(lèi)方法鍵合強(qiáng)度的影響,并提出了鍵合機(jī)理模型。對(duì)于親水鍵合,主要利用RCA溶液(氨水和雙氧水的混合水溶液)或食人魚(yú)溶液(濃硫酸和雙氧水的混合溶液)對(duì)潔凈拋光的晶圓表面進(jìn)行清洗,形成羥基(-OH)密度較高的親水表面,大氣環(huán)境中的水分子極易吸附于該親水表面。后在室溫條件下,將具有親水表面的兩片晶圓貼合到一起,根據(jù)反應(yīng)式(1),高溫退火過(guò)程中界面之間較弱的分子間作用力(范德華力和氫鍵)會(huì)轉(zhuǎn)化為較強(qiáng)的Si-O-Si共價(jià)鍵,從而獲得牢固的鍵合界面。
Si-OH+HO-Si→Si-O-Si+H2O (1)
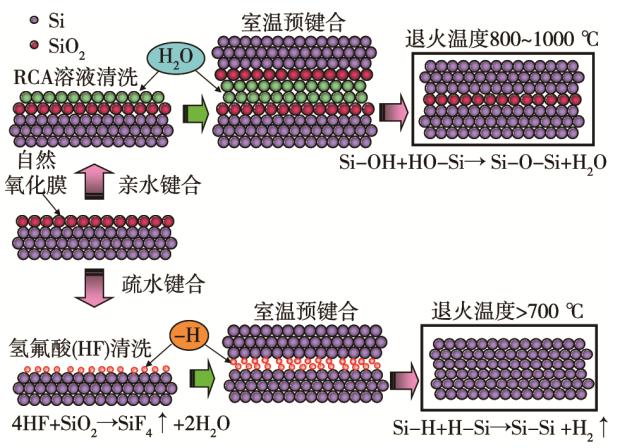
圖1 硅晶圓的親水鍵合和疏水鍵合原理
對(duì)于疏水鍵合,一般是利用氫氟酸(HF)去除硅片表面的自然氧化膜,硅片表面布滿(mǎn)具有疏水特性的硅氫鍵(Si-H),處理過(guò)的硅片先在室溫下直接貼合,后續(xù)的加熱退火過(guò)程則遵循反應(yīng)式(2),界面形成Si-Si共價(jià)鍵。
Si-H+H-Si→Si-Si+H2↑ (2)
硅晶圓親水和疏水表面結(jié)合能與退火溫度的關(guān)系曲線(xiàn)見(jiàn)圖2。當(dāng)退火溫度低于550 ℃時(shí),通過(guò)親水法獲得的鍵合能高于疏水鍵合法,而疏水法鍵合只有經(jīng)過(guò)較高的退火溫度,才能滿(mǎn)足鍵合晶圓后續(xù)加工所需克服的機(jī)械強(qiáng)度,但是無(wú)論采用哪種方法,均需要經(jīng)過(guò)較高溫度( >650 ℃ )的退火,方能獲得大于2.0J/m^2的鍵合能。由于高溫退火過(guò)程能夠誘發(fā)內(nèi)部元件的熱應(yīng)力,導(dǎo)致?lián)诫s元素的有害擴(kuò)散,損壞溫度敏感元件, 因此很大程度上限制了晶圓鍵合技術(shù)在微機(jī)電系統(tǒng)(MEMS)的制造和晶圓級(jí)封裝等方面的應(yīng)用。
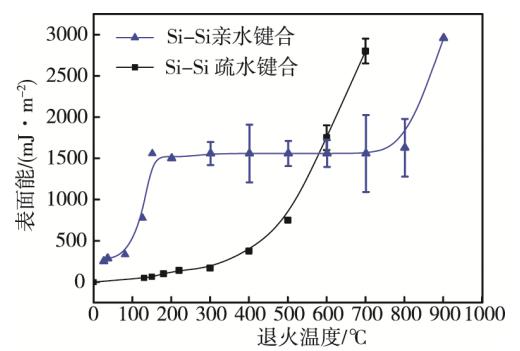
圖2 硅晶圓親水和疏水鍵合的表面結(jié)合能與退火溫度的關(guān)系
2.真空環(huán)境中的室溫鍵合
2.1 超高真空鍵合
超高真空鍵合(Ultra-high vacuum bonding)的誕生要追溯到20世紀(jì)70年代 ,美國(guó)國(guó)家航空航天局(NASA)在太空進(jìn)行實(shí)驗(yàn)時(shí),意外地發(fā)現(xiàn)超高真空環(huán)境中裸露金屬表面之間的粘附現(xiàn)象。眾所周知,將硅晶圓暴露在大氣環(huán)境中,其表面會(huì)瞬間生成數(shù)埃厚的自然氧化膜。一旦硅晶圓表面氧化膜在超高真空環(huán)境中被除去,再使?jié)崈魭伖夂蟮木A表面達(dá)到足夠近的接觸,通過(guò)相鄰材料界面之間的分子間作用力(范德華力或氫鍵),進(jìn)一步拉近兩個(gè)表面原子間的距離,從而使界面直接形成共價(jià)鍵。早在1964年,Smith和Gussenhoven就已經(jīng)開(kāi)展對(duì)石英與石英在超高真空環(huán)境下的鍵合研究,但其界面之間的鍵合主要依靠范德華力,因此獲得的鍵合強(qiáng)度較弱。1966年Haneman等人又對(duì)鍺的真空鍵合進(jìn)行了報(bào)道,并且實(shí)現(xiàn)了界面原子之間的共價(jià)鍵。由于真空鍵合對(duì)設(shè)備要求高,此后,有關(guān)真空環(huán)境鍵合的研究有所擱置。
1995年德國(guó)馬克斯-普朗克研究所G?sele教授的課題組對(duì)超高真空環(huán)境下硅-硅晶圓之間的鍵合工藝進(jìn)行了系統(tǒng)探索,其鍵合過(guò)程的原理見(jiàn)圖3。其表面處理過(guò)程與前文的疏水鍵合法相同,首先將硅晶圓浸入氫氟酸中,去除表面的自然氧化層,表面因覆蓋一層硅氫鍵而變得疏水。在室溫下將兩片疏水晶圓先預(yù)鍵合,隨后將鍵合后的晶圓轉(zhuǎn)移至超高真空腔體內(nèi),并將腔體內(nèi)的壓強(qiáng)降低至3x10^(-7)Pa,通過(guò)操縱器先將鍵合的兩片晶圓分離(疏水鍵合室溫下強(qiáng)度很低),然后將腔體內(nèi)的溫度升高至300~800℃,以使得表面殘余的氧化膜分解和表面吸附的氫發(fā)生解吸附,直至硅表面的氧化膜和吸附的氫去除完全,而后冷卻腔體至室溫。最后,通過(guò)真空機(jī)械操縱裝置,使兩片晶圓再次貼合,在無(wú)需任何外力及退火的情況下,完成室溫鍵合過(guò)程,鍵合強(qiáng)度可達(dá)到2.0 J/m^2。從鍵合界面的透射電子顯微鏡圖像中可以看出,Si-Si鍵合界面處不存在非晶態(tài)的中間層,原子排列整齊。該方法亦適用于Si-GaAs以及Si-InP的鍵合。
2.2 表面活化鍵合
真空鍵合的實(shí)現(xiàn)主要依賴(lài)于原子級(jí)清潔的表面具有極高的活性,并且極易在低溫甚至室溫下發(fā)生鍵合。表面活化鍵合(Surface activated bonding, SAB)的基本原理是在高真空環(huán)境中(<10^(?5)Pa),利用高速氬原子或氬離子轟擊晶圓表面,除去表面氧化膜及其他污染物。然后施加一定壓力,使兩個(gè)已被去除氧化膜的表面在高真空環(huán)境中緊密接觸,依靠化學(xué)鍵的作用,使表面能量降低,實(shí)現(xiàn)原子尺度上的牢固結(jié)合,在室溫(約25) ℃ 條件下能達(dá)良好的鍵合強(qiáng)度,無(wú)需后續(xù)的退火,消除了熱膨脹系數(shù)不匹配而造成的熱應(yīng)力的問(wèn)題。
表面活化鍵合方法的開(kāi)發(fā)主要始于20世紀(jì)90年代,日本東京大學(xué)的Suga教授課題組率先開(kāi)展室溫鍵合的研究,但起初所涉及的材料主要是Al-陶瓷、Al-Al、 Al-Si3N4、 Al-不銹鋼、 Al-Si、 Al-Al、Al-Al2O3、 Cu-Cu、 Cu-PbSn釬料等金屬間、金屬與陶瓷及金屬與半導(dǎo)體的鍵合。由于離子束轟擊后的表面活性極高,如果此過(guò)程是在非理想狀態(tài)下進(jìn)行的,那么二次氧化或者二次污染的問(wèn)題極易發(fā)生,因此,轟擊與鍵合的過(guò)程常常在超高真空環(huán)境下進(jìn)行(即使這樣,表面氧化及污染問(wèn)題依然存在,但程度要大大降低)。為此, Suga等人還專(zhuān)門(mén)開(kāi)發(fā)了表面活化鍵合設(shè)備。隨著Suga等人對(duì)這項(xiàng)技術(shù)的研究不斷深入,又將這項(xiàng)技術(shù)的應(yīng)用擴(kuò)展到半導(dǎo)體材料領(lǐng)域,并且利用Ar高速原子或 Ar離子轟擊晶圓表面,成功實(shí)現(xiàn)了Si-Si、 Si-GaAs以及Si-LiNbO3之間的鍵合,其鍵合原理見(jiàn)圖3。
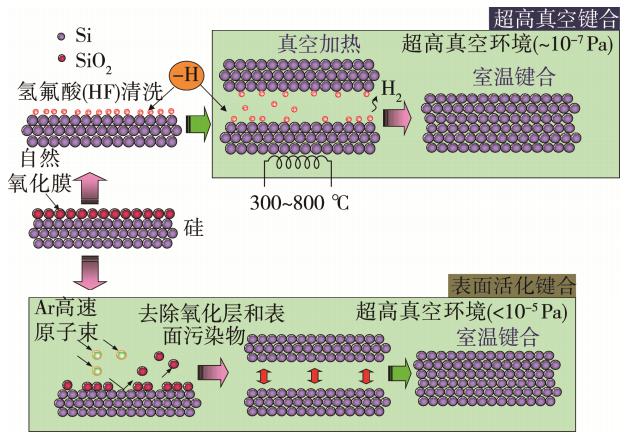
圖3 真空環(huán)境中的室溫鍵合原理
自此表面活化鍵合法已成功應(yīng)用于多種金屬、合金、半導(dǎo)體材料之間的室溫鍵合。雖然表面活化鍵合法自誕生伊始就受到半導(dǎo)體工業(yè)界的廣泛關(guān)注,但仍存在以下兩個(gè)問(wèn)題限制了該方法的推廣應(yīng)用:①該方法對(duì)氧化物的晶圓(如二氧化硅、石英及玻璃)并不適用,室溫鍵合強(qiáng)度很低,仍須退火工藝;②該方法需要高真空系統(tǒng),設(shè)備復(fù)雜昂貴。為了克服以上困難,近年來(lái)加拿大McMaster大學(xué)的Howlader教授和Kondou等人提出了納米層增強(qiáng)表面活化接合法,試圖擴(kuò)展表面活化鍵合法的應(yīng)用范圍,其效果和機(jī)理尚在研究中。
3.大氣環(huán)境中的室溫鍵合
雖然真空環(huán)境中的室溫鍵合具有諸多優(yōu)點(diǎn),但超高真空系統(tǒng)的高成本和設(shè)備復(fù)雜性很大程度限制了室溫鍵合方法的推廣。另一方面,大氣環(huán)境中的室溫鍵合方法越來(lái)越受到人們關(guān)注,其中等離子體活化鍵合法已成為低溫晶圓直接鍵合的主流。等離子體活化鍵合法與前文所述的硅熔鍵合法的原理十分類(lèi)似,只是在上述RCA溶液清洗后利用O2, N2, H2或Ar等離子體照射晶圓表面(或稱(chēng)之為活化),而后將兩晶圓在室溫下預(yù)鍵合到一起,經(jīng)過(guò)200~400℃的低溫退火后達(dá)到足夠高的鍵合強(qiáng)度,其鍵合原理見(jiàn)圖4。由于等離子體的產(chǎn)生和全部的鍵合過(guò)程都可在低真空度環(huán)境或大氣下進(jìn)行,不需要高真空系統(tǒng),操作方便且成本相對(duì)較低,受到了研究者和工業(yè)界的重視,近年來(lái)是一個(gè)研究熱點(diǎn)。除了Si晶圓之間的鍵合以外,該方法還適用于硅與III-VI族化合物半導(dǎo)體的鍵合,但存在的問(wèn)題是在低溫退火過(guò)程中,晶圓的鍵合界面中間往往出現(xiàn)大量的孔洞(Void),這些退火孔洞嚴(yán)重降低了器件的成品率和可靠性。張軒雄等人認(rèn)為嚴(yán)格優(yōu)化等離子體的照射時(shí)間能很大程度上抑制退火孔洞的生成。
Plach等人考察了等離子體活化鍵合機(jī)理,研究表明等離子體表面活化一方面被認(rèn)為可增加單位面積表面的羥基(-OH)基團(tuán)密度,另一方面是等離子體與表面的相互作用,造成晶圓表下層區(qū)域形成的多孔結(jié)構(gòu)能夠存儲(chǔ)水,促進(jìn)鍵合界面水分子的擴(kuò)散,從而在宏觀上提高了鍵合強(qiáng)度,但多孔結(jié)構(gòu)內(nèi)多余的水分子亦會(huì)在后續(xù)退火過(guò)程和硅晶圓反應(yīng),產(chǎn)生大量氫氣聚集形成鍵合界面孔洞。等離子體照射對(duì)表面的影響被視為雙刃劍,一方面提高了晶圓表面OH基團(tuán)密度,另一方面產(chǎn)生的多孔結(jié)構(gòu)吸附過(guò)量的水分子,成為后續(xù)退火過(guò)程中產(chǎn)生界面孔洞的隱患。
為了進(jìn)一步降低等離子體活化鍵合工藝過(guò)程中的退火溫度,Howlader等人開(kāi)發(fā)出了一項(xiàng)兩種等離子體按順序活化的鍵合方法(Sequential plasma activated bonding)。該方法首先采用反應(yīng)離子刻蝕型(RIE)氧等離子體處理晶圓,而后采用微波等離子產(chǎn)生的氮自由基再次活化晶圓表面,從而使得硅和石英等晶圓之間在室溫條件下獲得了較高的鍵合強(qiáng)度。除此以外,美國(guó)Ziptronix公司基于多步驟表面干濕法,處理開(kāi)發(fā)出了一種氧化物晶圓的低溫直接鍵合技術(shù),被命名為開(kāi)發(fā)的ZiBond?技術(shù),其工藝流程見(jiàn)圖5。該工藝流程的關(guān)鍵是包含氫氟酸和氨水兩個(gè)處理步驟,在空氣氣氛中室溫儲(chǔ)存60h后 ,SiO2-SiO2晶圓之間的鍵合強(qiáng)度可達(dá)到硅母材的斷裂能(約2.5 J/m^2)。由于可以通過(guò)熱氧化或化學(xué)氣相沉積的方法在多種半導(dǎo)體材料上制備氧化硅層,因此 ZiBond?技術(shù)適用于多種晶圓材料的鍵合,然而該方法仍需要包括濕法化學(xué)溶液清洗、加熱和等離子體處理在內(nèi)的一系列表面處理步驟,工藝較為復(fù)雜且耗時(shí)相對(duì)較長(zhǎng)。

圖4 等離子體活化鍵合原理
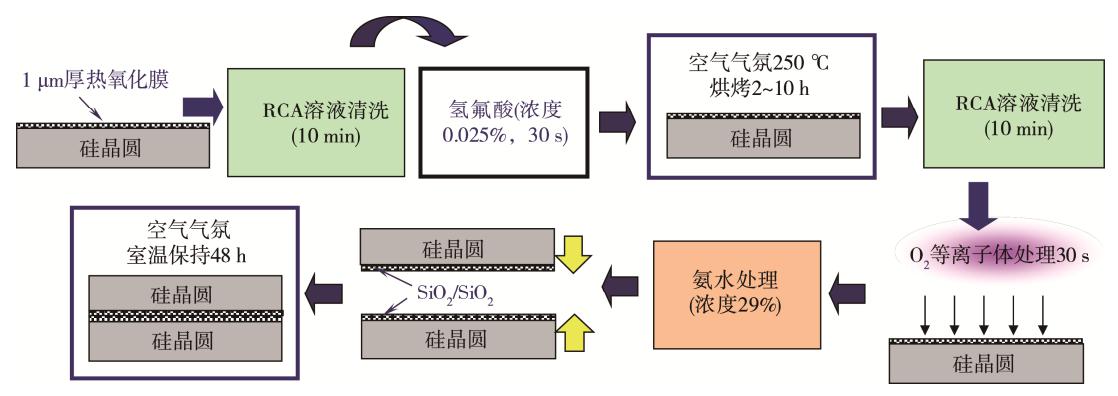
圖5 ZiBond?技術(shù)工藝流程
4.含氟等離子體活化室溫鍵合技術(shù)
近年來(lái),哈爾濱工業(yè)大學(xué)與日本東京大學(xué)合作開(kāi)發(fā)出了一項(xiàng)含氟等離子體活化室溫鍵合技術(shù)(Fluorine containing plasma activated bonding)。 該方法主要是在傳統(tǒng)的氧等離子體的氣氛中添加極少量的四氟化碳(CF4),利用含氟的等離子體處理硅晶圓表面,在大氣環(huán)境中室溫鍵合,經(jīng)空氣氣氛24h室溫存儲(chǔ)后,無(wú)需加熱即得到與硅母材斷裂能(約2.5 J/m^2)接近的鍵合強(qiáng)度,實(shí)現(xiàn)了Si-Si晶圓的室溫鍵合。該方法具有成本低、操作簡(jiǎn)單和無(wú)毒無(wú)害等優(yōu)點(diǎn)。含氟等離子體活化的硅晶圓室溫鍵合結(jié)果及鍵合界面見(jiàn)圖6。
在實(shí)現(xiàn)Si-Si鍵合的基礎(chǔ)上,王晨曦等人將含氟等離子體活化鍵合方法的適用性由Si材料擴(kuò)展到Si基材料范圍,成功應(yīng)用于Si-SiO2、SiO2-SiO2以及Si-Si3N4晶圓的室溫鍵合,彌補(bǔ)了表面活化鍵合方法對(duì)SiO2材料鍵合強(qiáng)度低的不足。對(duì)于等離子活化鍵合機(jī)理的研究表明,低溫退火過(guò)程中鍵合界面間的水分子能夠滲透進(jìn)入表面氧化層,對(duì)鍵合強(qiáng)度的提高有至關(guān)重要的作用。經(jīng)含氟的氧等離子體處理后的硅晶圓表面會(huì)形成氧氟化硅,與氧等離子體處理后表面產(chǎn)生的二氧化硅相比,含氟等離子體產(chǎn)生的低密度氧氟化硅對(duì)水的穿透更敏感,更容易在水應(yīng)力腐蝕的作用下發(fā)生軟化。如圖7所示,室溫放置過(guò)程中吸收水后的氧氟化硅層體積發(fā)生膨脹,使晶圓之間原子尺度接觸面積增大,形成更多的Si-O-Si共價(jià)鍵,因此在室溫保存一定時(shí)間后能獲得很高的鍵合強(qiáng)度。
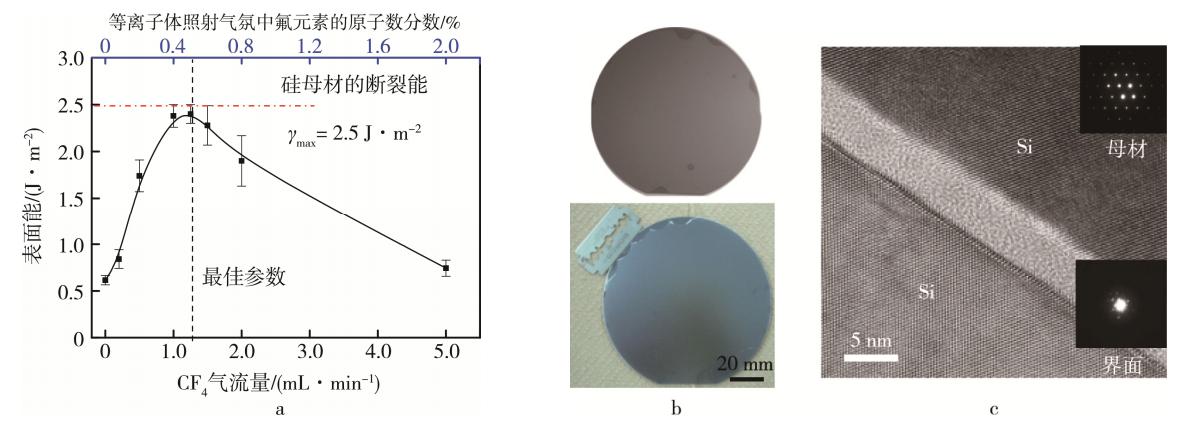
圖6 含氟等離子體活化的硅晶圓室溫鍵合結(jié)果及鍵合界面
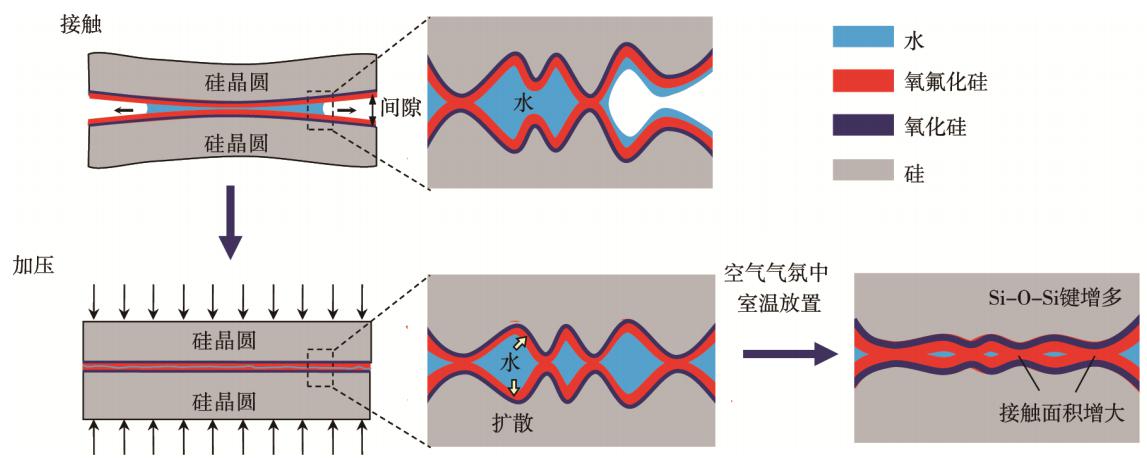
圖7 含氟等離子體活化室溫鍵合機(jī)理示意圖
另一方面,等離子體添加少量氟能夠部分解決等離子活化鍵合中的退火孔洞問(wèn)題。退火孔洞一般被認(rèn)為是退火過(guò)程中界面的部分水分子滲進(jìn)硅基體,發(fā)生氧化過(guò)程見(jiàn)反應(yīng)式(3),產(chǎn)生氫氣(H2)聚集于界面處而造成的。
Si+H2O→SiO2+H2↑ (3)
由此可見(jiàn),硅表面吸附的水分子量對(duì)鍵合強(qiáng)度及退火孔洞生成有著直接的影響。研究發(fā)現(xiàn)通過(guò)調(diào)節(jié)等離子體氣氛中的氟含量,能夠控制硅晶圓表面水分子的吸附量,減少了界面間多余水分子,在獲得牢固的室溫鍵合界面的同時(shí),亦能夠大幅度減少退火孔洞的生成。
5.結(jié)語(yǔ)
以晶圓直接鍵合為主題,簡(jiǎn)要介紹了從傳統(tǒng)的高溫硅熔鍵合到室溫鍵合的各方法的基本原理、技術(shù)特點(diǎn)和研究現(xiàn)狀。在半導(dǎo)體器件不斷朝著高性能、多功能和超小型化發(fā)展的同時(shí),三維光電集成、微機(jī)電系統(tǒng)(MEMS)和微納流控器件的研究也加快了步伐。低溫(<200 ) ℃ 甚至是室溫條件下的多種材料的鍵合技術(shù)在新型器件的制造過(guò)程中具有不可替代的重要作用。開(kāi)發(fā)新的簡(jiǎn)單實(shí)用的低溫及室溫鍵合方法,綠色環(huán)保的鍵合工藝及低成本的鍵合設(shè)備,并不斷提高鍵合性能和可靠性,實(shí)現(xiàn)多功能系統(tǒng)集成與制造,將成為進(jìn)一步研究目標(biāo)和未來(lái)的努力方向。
文章來(lái)源:哈爾濱工業(yè)大學(xué) 作者:王晨曦、王特、許繼開(kāi)、王源、田艷紅 DOI:10.3969/j.issn.1674-6457.2018.01.008
關(guān)鍵詞:室溫鍵合;硅熔鍵合;超高真空鍵合;表面活化鍵合;等離子體活化鍵合
免責(zé)聲明:以傳播知識(shí)、有益學(xué)習(xí)和研究為宗旨。 轉(zhuǎn)載僅供參考學(xué)習(xí)及傳遞有用信息,版權(quán)歸原作者所有,如侵犯權(quán)益,請(qǐng)聯(lián)系刪除。

