芯片光刻的流程詳解(上)
在集成電路的制造過程中,有一個重要的環節——光刻,正因為有了它,我們才能在微小的芯片上實現功能。現代刻劃技術可以追溯到190年以前,1822年法國人Nicephore niepce在各種材料光照實驗以后,開始試圖復制一種刻蝕在油紙上的印痕(圖案),他將油紙放在一塊玻璃片上,玻片上涂有溶解在植物油中的瀝青。經過2、3小時的日曬,透光部分的瀝青明顯變硬,而不透光部分瀝青依然軟并可被松香和植物油的混合液洗掉。通過用強酸刻蝕玻璃板,Niepce在1827年制作了一個d’Amboise主教的雕板相的復制品。
Niepce的發明100多年后,即第二次世界大戰期間才第一應用于制作印刷電路板,即在塑料板上制作銅線路。到1961年光刻法被用于在Si上制作大量的微小晶體管,當時分辨率5um,如今除可見光光刻之外,更出現了X-ray和荷電粒子刻劃等更高分辨率方法。
所謂光刻,根據維基百科的定義,這是半導體器件制造工藝中的一個重要步驟,該步驟利用曝光和顯影在光刻膠層上刻畫幾何圖形結構,然后通過刻蝕工藝將光掩模上的圖形轉移到所在襯底上。這里所說的襯底不僅包含硅晶圓,還可以是其他金屬層、介質層,例如玻璃、SOS中的藍寶石。
光刻的基本原理是利用光致抗蝕劑(或稱光刻膠)感光后因光化學反應而形成耐蝕性的特點,將掩模板上的圖形刻制到被加工表面上。

光刻不是一個簡單的過程,它要經歷很多步驟:
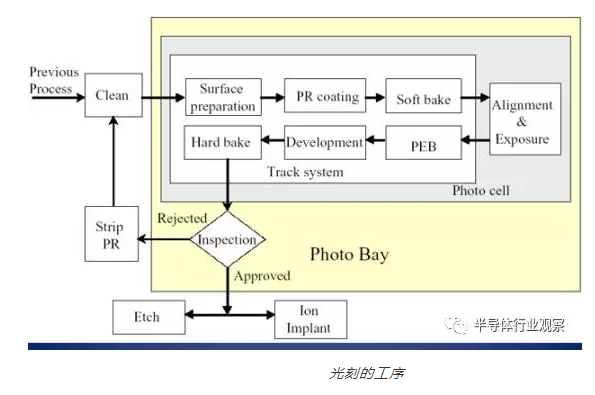
下面我們來詳細介紹一下光刻的工序:
一、清洗硅片(Wafer Clean)
清洗硅片的目的是去除污染物去除顆粒、減少針孔和其它缺陷,提高光刻膠黏附性基本步驟:化學清洗——漂洗——烘干。
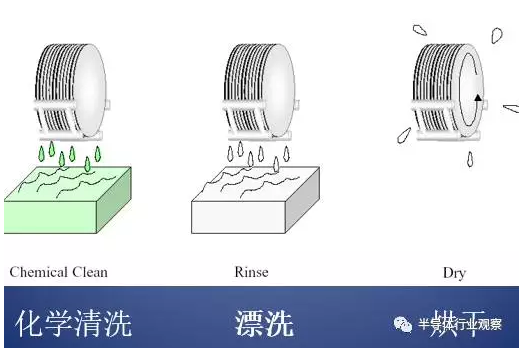
硅片經過不同工序加工后,其表面已受到嚴重沾污,一般講硅片表面沾污大致可分在三類:
A. 有機雜質沾污: 可通過有機試劑的溶解作用,結合超聲波清洗技術來去除。
B. 顆粒沾污:運用物理的方法可采機械擦洗或超聲波清洗技術來去除粒徑 ≥ 0.4 μm顆粒,利用兆聲波可去除 ≥ 0.2 μm顆粒。
C. 金屬離子沾污:必須采用化學的方法才能清洗其沾污,硅片表面金屬雜質沾污有兩大類:
a. 一類是沾污離子或原子通過吸附分散附著在硅片表面。
b. 另一類是帶正電的金屬離子得到電子后面附著(尤如“電鍍”)到硅片表面。硅拋光片的化學清洗目的就在于要去除這種沾污,一般可按下述辦法進行清洗去除沾污。
(1) 使用強氧化劑使“電鍍”附著到硅表面的金屬離子、氧化成金屬,溶解在清洗液中或吸附在硅片表面。
(2)用無害的小直徑強正離子(如H+)來替代吸附在硅片表面的金屬離子,使之溶解于清洗液中。
(3)用大量去離水進行超聲波清洗,以排除溶液中的金屬離子。
自1970年美國RCA實驗室提出的浸泡式RCA化學清洗工藝得到了廣泛應用,1978年RCA實驗室又推出兆聲清洗工藝,近幾年來以RCA清洗理論為基礎的各種清洗技術不斷被開發出來,例如:美國FSI公司推出離心噴淋式化學清洗技術、美國原CFM公司推出的Full-Flow systems封閉式溢流型清洗技術、美國VERTEQ公司推出的介于浸泡與封閉式之間的化學清洗技術(例Goldfinger Mach2清洗系統)、美國SSEC公司的雙面檫洗技術(例M3304 DSS清洗系統)、 日本提出無藥液的電介離子水清洗技術(用電介超純離子水清洗)使拋光片表面潔凈技術達到了新的水平、以HF / O3為基礎的硅片化學清洗技術。
二、預烘和底膠涂覆(Pre-bake and Primer Vapor)
由于光刻膠中含有溶劑,所以對于涂好光刻膠的硅片需要在80度左右的。硅片脫水烘焙能去除圓片表面的潮氣、增強光刻膠與表面的黏附性、通常大約100 °C。這是與底膠涂覆合并進行的。
底膠涂覆增強光刻膠(PR)和圓片表面的黏附性。廣泛使用: (HMDS)六甲基二硅胺、在PR旋轉涂覆前HMDS蒸氣涂覆、PR涂覆前用冷卻板冷卻圓片。
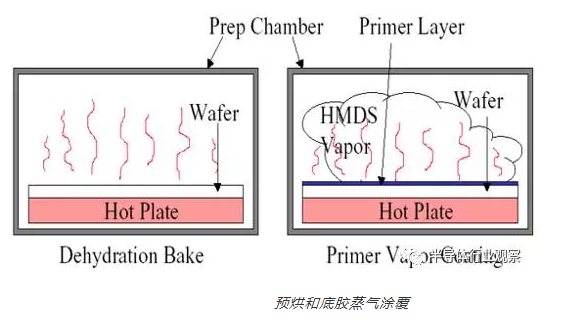
三、光刻膠涂覆(Photoresist Coating)
光刻膠涂覆通常的步驟是在涂光刻膠之前,先在900-1100度濕氧化。氧化層可以作為濕法刻蝕或B注入的膜版。作為光刻工藝自身的第一步,一薄層的對紫外光敏感的有機高分子化合物,即通常所說的光刻膠,要涂在樣品表面(SiO2)。首先光刻膠被從容器中取出滴布到置于涂膠機中的樣品表面,(由真空負壓將樣品固定在樣品臺上),樣品然后高速旋轉,轉速由膠粘度和希望膠厚度確定。在這樣的高速下,膠在離心力的作用下向邊緣流動。
涂膠工序是圖形轉換工藝中最初的也是重要的步驟。涂膠的質量直接影響到所加工器件的缺陷密度。為了保證線寬的重復性和接下去的顯影時間,同一個樣品的膠厚均勻性和不同樣品間的膠厚一致性不應超過±5nm(對于1.5um膠厚為±0.3%)。
光刻膠的目標厚度的確定主要考慮膠自身的化學特性以及所要復制圖形中線條的及間隙的微細程度。太厚膠會導致邊緣覆蓋或連通、小丘或田亙狀膠貌、使成品率下降。在MEMS中、膠厚(烤后)在0.5-2um之間,而對于特殊微結構制造,膠厚度有時希望1cm量級。在后者,旋轉涂膠將被鑄膠或等離子體膠聚合等方法取代。常規光刻膠涂布工序的優化需要考慮滴膠速度、滴膠量、轉速、環境溫度和濕度等,這些因素的穩定性很重要。
在這里說一下,光刻膠的主要成分有一種聚合物(樹脂)、敏化劑和溶劑。聚合物在被輻照時結構變化,溶劑使其能被甩膠并在樣品表面形成薄膜,敏化劑控制聚合相的化學反應。不含有敏化劑的光刻膠有時稱為單元或一元體系,而含有敏化劑使則稱為二元體系。溶劑或其它添加物通常不計入元數,因為它們不直接參與光刻膠的光化學反應。根據性質的不一樣,光刻膠可以分為正膠和負膠。
在工藝發展的早期,負膠一直在光刻工藝中占主導地位,隨著VLSI IC和2~5微米圖形尺寸的出現,負膠已不能滿足要求。隨后出現了正膠,但正膠的缺點是粘結能力差。
用正膠需要改變掩膜版的極性,這并不是簡單的圖形翻轉。因為用掩膜版和兩種不同光刻膠結合,在晶園表面光刻得到的尺寸是不一樣的,由于光在圖形周圍的衍射效應,使得用負膠和亮場掩膜版組合在光刻膠層上得到的圖形尺寸要比掩膜版上的圖形尺寸小。用正膠和暗場掩膜版組合會使光刻膠層上的圖形尺寸變大。
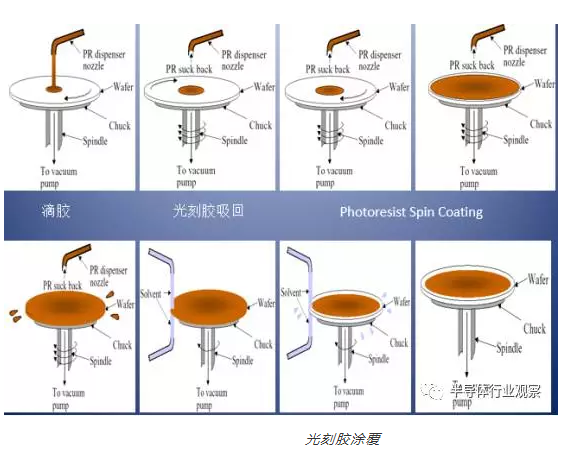
四、前烘(Soft Bake)
完成光刻膠的涂抹之后,需要進行軟烘干操作,這一步驟也被稱為前烘。前烘能夠蒸發光刻膠中的溶劑溶劑、能使涂覆的光刻膠更薄。
在液態的光刻膠中,溶劑成分占65%-85%。雖然在甩膠之后,液態的光刻膠已經成為固態的薄膜,但仍有10%-30%的溶劑,容易沾污灰塵。通過在較高溫度下進行烘培,可以使溶劑從光刻膠中揮發出來(前烘后溶劑含量降至5%左右),從而降低了灰塵的沾污。同時,這一步驟還可以減輕因高速旋轉形成的薄膜應力,從而提高光刻膠 襯底上的附著性。在前烘過程中,由于溶劑揮發,光刻膠厚度也會減薄,一般減薄的幅度為10%-20%左右。
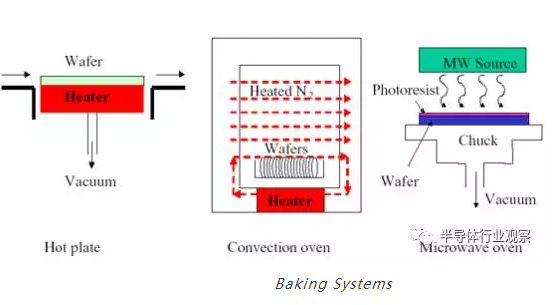
五、對準(Alignment)
光刻對準技術是曝光前一個重要步驟作為光刻的三大核心技術之一,一般要求對準精度為最細線寬尺寸的 1/7---1/10。隨著光刻分辨力的提高 ,對準精度要求也越來越高 ,例如針對 45am線寬尺寸 ,對準精度要求在5am 左右。
受光刻分辨力提高的推動 ,對準技術也經歷 迅速而多樣的發展 。從對準原理上及標記結 構分類 ,對準技術從早期的投影光刻中的幾何成像對準方式 ,包括視頻圖像對準、雙目顯微鏡對準等,一直到后來的波帶片對準方式 、干涉強度對準 、激光外差干涉以及莫爾條紋對準方式 。從對準信號上分 ,主要包括標記的顯微圖像對準 、基于光強信息的對準和基于相位信息對準。
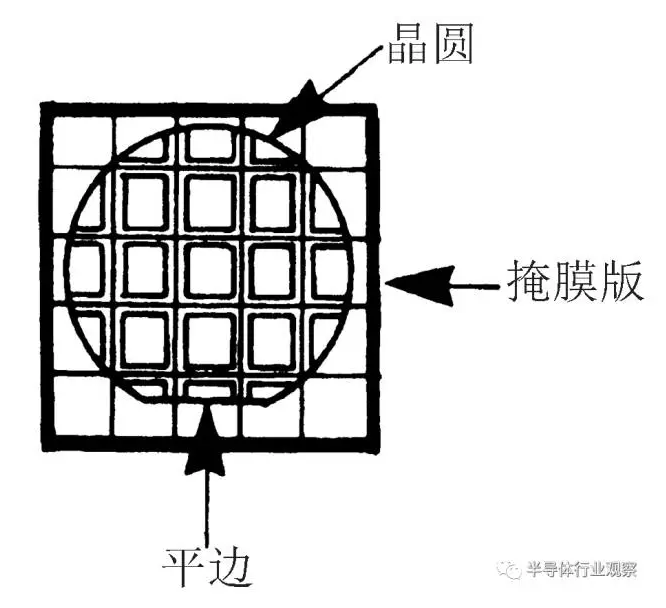
對準法則是第一次光刻只是把掩膜版上的Y軸與晶園上的平邊成90?,如圖所示。接下來的掩膜版都用對準標記與上一層帶有圖形的掩膜對準。對準標記是一個特殊的圖形(見圖),分布在每個芯片圖形的邊緣。經過光刻工藝對準標記就永遠留在芯片表面,同時作為下一次對準使用。
對準方法包括:
a、預對準,通過硅片上的notch或者flat進行激光自動對準
b、通過對準標志,位于切割槽上。另外層間對準,即套刻精度,保證圖形與硅片上已經存在的圖形之間的對準。
(文章來源:半導體行業觀察 轉載僅供參考學習及傳遞有用信息,版權歸原作者所有,如侵犯權益,請聯系刪除)

